
IBM využívá tekutého kovu pro chlazení a zároveň i napájení uvnitř 3D čipů
Princip je jednoduchý. V jednotlivých vrstvách čipů jsou vytvořeny kanálky, které jsou naplněné tekutým kovem. Ten dokáže dodat energii a následně odvést teplo.
Čím rychlejší jsou dnes procesory, grafické a ostatní čipy, tím rychleji potřebují komunikovat s ostatními částmi systému, zejména s operační pamětí. Již několik společností se shodlo, že se začne vývoj čipů ubírat k vrstvení, čímž nám vzniknou jakési 3D čipy nebo také kvádry, krychle. Podobný koncept už používají některé mobilní SoC čipy (System on Chip). V první vrstvě je celá logika, všechna výpočetní jádra a komunikační moduly, ve vrstvě druhé je následně RAM paměť.
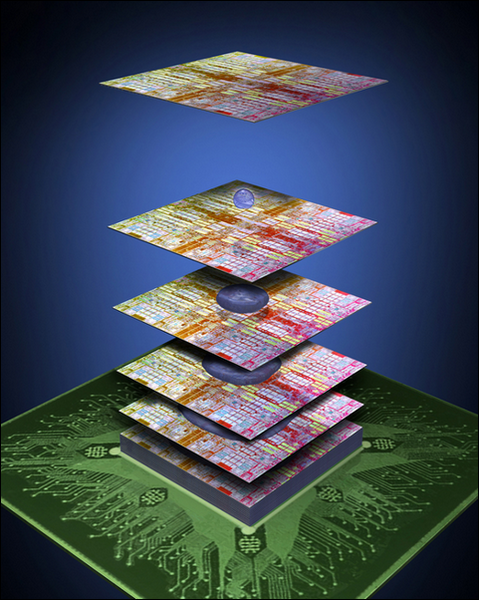
IBM pracuje na mnoha výzkumech a většina z nich vychází z principu fungování našeho mozku. Stejně tak je navržena i technologie Through Silicon Via (TSV, Cesta Skrz Křemík). Nejefektivnějším řešením, jsou nejkratší vzdálenosti mezi jednotlivými částmi čipu, z čehož se dostaneme ke 3D návrhu. Ale jsou zde dva problémy. Jak jednotlivé vrstvy napájet a hlavně chladit. IBM vymyslelo princip, při kterém jsou ve všech vrstvách křemíku vytvořené díry a jsou vyplněny tekutým kovem, konkrétně je zde Vanadium.
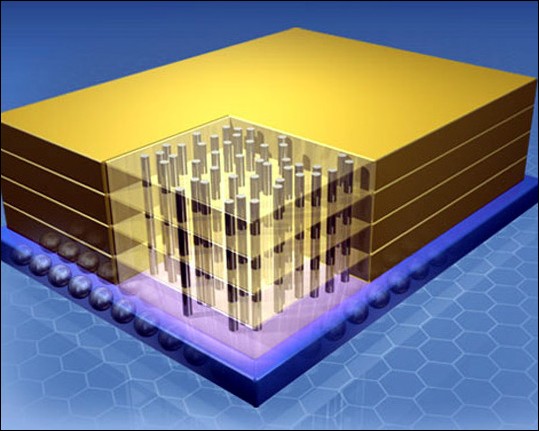
Micron Hybrid Memory Cube
Tento tekutý kov je v připravených kanálcích a plní rovnou dvě funkce. Dodává jednotlivým vrstvám proud a odvádí od nich teplo. Tato technologie je zatím v laboratořích IBM, ale prý funguje perfektně s několika desítkami vrstev. Kdy se ale dostane do běžného návrhu čipů zatím není jasné. Micron již pracuje na několikavrstvých NAND flash pamětí (Hybrid Memory Cube), kde by se tato technologie pravděpodobně bude využívat.
„Lidský mozek je 10 000× hustší a efektivnější, než kterýkoliv dnešní počítač. Je to proto, že používá jednu, extrémně efektivní síť kapilár a cév na dopravu tepla a energie, všechny ve stejnou dobu,“ IBM.
Zdroj: NordicHardware





